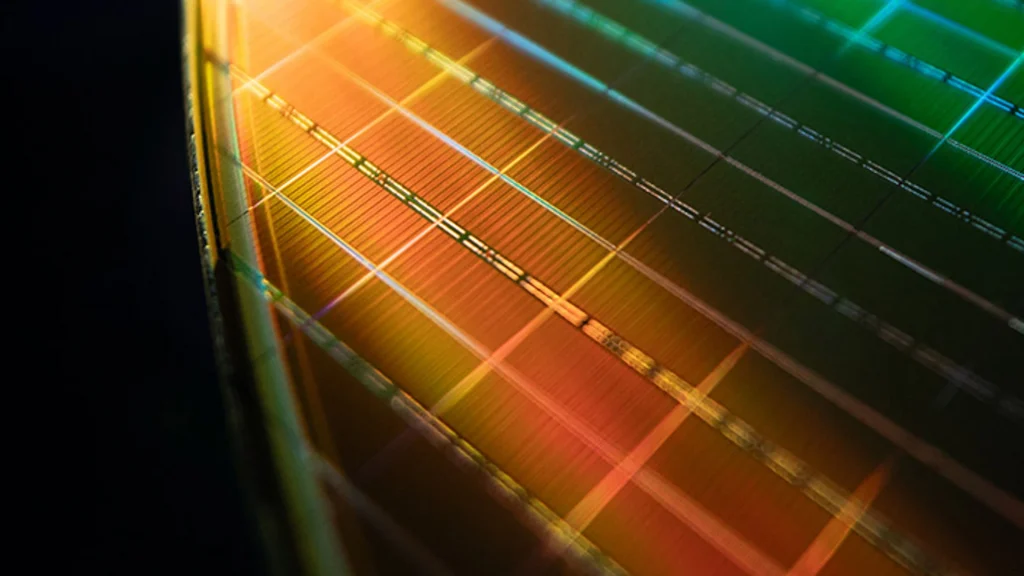
روسیه نقشه راه ابزار ساخت تراشه لیتوگرافی EUV را تا سال 2037 ترسیم میکند
موسسه فیزیک ریزساختار آکادمی علوم روسیه (از طریق دیمیتری کوزنتسوف) یک نقشه راه بلندمدت برای ابزارهای لیتوگرافی فرابنفش شدید (EUV) داخلی که در طول موج 11.2 نانومتر کار میکنند، ارائه کرده است که اطلاعاتی را که این سازمان دسامبر گذشته به اشتراک گذاشته بود، گسترش میدهد. پروژه جدید از سال 2026 با استفاده از فناوری ساخت 40 نانومتر آغاز شده و تا سال 2037 با ادغام فرآیندهای ساخت زیر 10 نانومتر ادامه مییابد. آخرین نقشه راه واقعبینانهتر از برخی نقشههای قبلی به نظر میرسد، اما هنوز باید قابلیت اجرایی خود را ثابت کند. علاوه بر این، در صورت اجرایی بودن، ممکن است برای اهداف تجاری استفاده نشود.
اولین چیزی که به چشم میخورد این است که سیستمهای EUV* پیشنهادی از تکرار معماری ابزارهای ASML اجتناب میکنند. در عوض، برنامه این است که از مجموعهای کاملاً متفاوت از فناوریها استفاده شود: لیزرهای هیبریدی حالت جامد، منابع نور مبتنی بر پلاسمای زنون، و آینههای ساخته شده از روتنیوم و بریلیوم (Ru/Be) که نور را در طول موج 11.2 نانومتر منعکس میکنند. انتخاب زنون به جای قطرات قلع در ابزارهای EUV شرکت ASML، زبالههایی را که به فوتوماسکها آسیب میرسانند، از بین میبرد که به طور چشمگیری نگهداری را کاهش میدهد. در همین حال، در مقایسه با ابزارهای DUV شرکت ASML، پیچیدگی کمتر به معنای اجتناب از سیالات غوطهوری با فشار بالا و مراحل چند الگویی برای گرههای پیشرفته است.
نقشه راه شامل سه مرحله اصلی است.
- اولین سیستم، که برای سالهای 2026-2028 برنامهریزی شده است، یک دستگاه لیتوگرافی با قابلیت 40 نانومتر با یک عدسی دو آینهای، دقت همپوشانی 10 نانومتر، میدان نوردهی تا 3×3 میلیمتر و توان عملیاتی بیش از پنج ویفر در ساعت است.
- مرحله دوم (2029-2032) یک اسکنر 28 نانومتری (با پتانسیل 14 نانومتر) را معرفی میکند که از یک سیستم نوری چهار آینهای استفاده میکند. این سیستم دقت همپوشانی 5 نانومتر، میدان نوردهی 26×0.5 میلیمتر و خروجی بیش از 50 ویفر در ساعت را ارائه میدهد.
- سیستم نهایی (2033-2036) تولید زیر 10 نانومتر را با پیکربندی شش آینهای، تراز همپوشانی 2 نانومتر و اندازههای میدان تا 26×2 میلیمتر هدف قرار میدهد. این سیستم برای ارائه توان عملیاتی بالای 100 ویفر در ساعت طراحی شده است.
از نظر وضوح، انتظار میرود این ابزارها طیفی از 65 نانومتر تا 9 نانومتر را پشتیبانی کنند که با الزامات بسیاری از لایههای حیاتی امروزی و آینده در سالهای 2025-2027 مطابقت دارد. هر نسل دقت نوری و کارایی اسکن را پیشرفت میدهد، در حالی که احتمالاً ساختار هزینه هر واحد را در مقایسه با پلتفرمهای Twinscan NXE و EXE شرکت ASML به طور قابل توجهی پایینتر نگه میدارد.
قابل ذکر است که توسعهدهندگان چندین مزیت غیرمنتظره را از استفاده از EUV برای گرههای قدیمیتر ادعا میکنند. با این حال، آنها هرگز به پیچیدگیهای ناشی از استفاده از لیزر با طول 11.2 نانومتر (آینههای مختلف، ابزارهای مختلف برای پولیش آینهها، اپتیکهای مختلف، منبع نور متفاوت، واحدهای منبع تغذیه متفاوت، مقاومت، فقط برای ذکر چند مورد) اشاره نمیکنند، که یک طول موج غیر استاندارد صنعتی در زمینه لیتوگرافی EUV است. برای گسترش نقشه راه، روی توییت زیر کلیک کنید.
به طور کلی، این نقشه راه ممکن است طرح روسیه برای دستیابی به خودکفایی در تولید تراشه را با دور زدن محدودیتهای سنتی EUV ترسیم کند. با این حال، مشخص نیست که این طرح چقدر قابل اجرا است، زیرا این امر به معنای جهش از کل صنعت است، چیزی که هنوز ثابت نشده است.
به جای هدف قرار دادن حداکثر توان عملیاتی برای کارخانههای فوقمقیاس، این ابزارها برای پذیرش مقرونبهصرفه توسط کارخانههای کوچکتر طراحی شدهاند. با ارائه یک سیستم لیتوگرافی تمیز، کارآمد و مقیاسپذیر که نیازی به غوطهوری یا پلاسمای مبتنی بر قلع ندارد، پلتفرم روسی ممکن است برای مشتریان بینالمللی که در حال حاضر از اکوسیستم ASML محروم هستند نیز جذاب باشد. در صورت تحقق کامل، این پروژه میتواند تولید تراشههای پیشرفته را برای مصارف داخلی و صادراتی با هزینههای سرمایهای و عملیاتی به طور قابل توجهی پایینتر امکانپذیر سازد.
*سیستمهای EUV زمانی اشعه ایکس نرم نامیده میشدند، از این رو اسلاید روسی به لیتوگرافی ‘röntgen’ اشاره دارد.
- کولبات
- مهر 6, 1404
- 45 بازدید







